AZ MIR 701 Photoresist (29 CPS) - 3.785 l












Product information "AZ MIR 701 Photoresist (29 CPS) - 3.785 l"
AZ® MIR 701 (29CPS)
High Resolution and Temperature Stability
General Information
AZ® 701 MIR (29CPS) is a positive resist (g-, h- and i-line sensitive) in the medium resist film thickness range, whose main applications are as a resist mask for dry etching, RIE, or lift-off processes.

300 nm resist lines attained with the AZ® 701 MIR
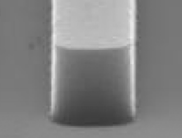
1.2µm structure after 130°C hardbake
Product Features
AZ® 701 MIR (29CPS) is optimized for steep resist sidewalls and high stability against thermal softening (softening temperature approx. 130°C). It achieves a resist film thickness of approx. 2µm at a spin speed of 4000 rpm. If thinner layers or a higher resolution are desired, the use of the lower-viscosity AZ® 701 MIR (14CPS) is recommended. Alternatively, AZ® 701 MIR (14CPS) can easily be heavily diluted with PGMEA = AZ® EBR Solvent. For wet-chemical etching, resists from the AZ® 1500 series with optimized resist adhesion are recommended.
Developers
For development, we recommend either TMAH-based developers such as AZ® 326 MIF or AZ® 726 MIF, the NaOH-based AZ® 351B, and if the requirements for selectivity are not too high, the KOH-based AZ® 400K. With AZ® 351B or AZ® 400K, it may be advisable to work with a higher diluted developer (for example 1:5 to 1:6) instead of the usual 1:4 dilution to achieve very fine resist structures or better controllable development times. On alkaline-sensitive substrate materials such as aluminum, we recommend the aluminum-compatible AZ® Developer in a 1:1 dilution.
Removers
If the resist structures have not been thermally cross-linked by plasma processes, ion implantation or high temperatures (> approx. 140 °C), all common removers such as AZ® 100 Remover, DMSO or many other organic solvents (e.g. acetone rinsed with isopropyl alcohol) are suitable for removing the resist layer. For cross-linked resist structures, high-performance strippers such as the NMP-free TechniStrip P1316 or AZ® 920 Remover are recommended, and in the case of alkaline-sensitive substrate materials (such as aluminum), the TechniStrip MLO 07.
Thinning/ Edge Bead Removal
PGMEA = AZ® EBR Solvent can generally be used as a thinner for spin coating, which can also be used to remove edge ridges if necessary.
Further Information
Our safety data sheets and some of our technical data sheets are password-protected.
You will receive the access data after completing the form.
The access data for the data sheets are not your login data from our shop!
MSDS:
Safety Data Sheet AZ® MIR 701 (29CPS) Photoresist english
Safety Data Sheet AZ® MIR 701 (29CPS) Fotolack german
TDS:
Technical Data Sheet AZ® MIR 701 Series english
Application Notes:
Further Information about Photoresist Processing
Related products
Developer
Remover




































