AZ ECI 3012 Photoresist - 3.785 l












Produktinformationen "AZ ECI 3012 Photoresist - 3.785 l"
AZ® 3012
Hohe Auflösung mit breitem Prozessfenster
Allgemeine Informationen
Der AZ® ECI 3012 gehört zur AZ® ECI 3000er Serie positiver Dünnlacke (g-, h-und i-line empfindlich), deren Hauptanwendungen der Einsatz als Lackmaske für trockenchemischen Ätzen, RIE, Ionenimplantation oder auch Lift-off Prozesse sind.
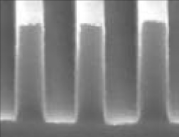
450 nm resist Linien mit dem AZ® ECI 3012 bei einer Schichtdicke von ca. 1.2 µm.
Produkteigenschaften
Die AZ® ECI 3000 Lackfamilie ist auf steile Lackflanken sowie eine hohe Stabilität gegen thermisches Verrunden (Erweichungstemperatur ca. 125 °C) optimiert. Die AZ® ECI 3000er Lacke benötigen eine, verglichen mit anderen Positivlacken, deutlich geringere Lichtdosis, entwickeln aber dennoch rasch.
Der AZ® ECI 3012 deckt mit ca. 1,3 µm Lackschichtdicke bei 3000 U/min mit angepassten Schleuderprofilen den Lackschichtdickenbereich von ca. 1.0 - 1.8 µm ab. Dieser Lack wird häufig zum Trockenätzen, RIE oder Lift-off Prozessen und erlaubt unter optimierten Prozessparametern eine Auflösung im Submikrometerbereich. Falls eine so hohe Auflösung nicht erforderlich ist, kann ein etwas dickerer Lack dieser Reihe (zum Beispiel AZ® ECI 3027) sinnvoll sein. Falls dünnere Lackschichten erforderlich sind, empfiehlt sich der AZ® ECI 3007, alternativ eine Verdünnung des AZ® ECI 3012 mit PGMEA = AZ® EBR Solvent. Für Anwendungen mit hohen Anforderungen an eine sehr gute Lackhaftung wie nasschemisches Ätzen sowie die galvanische Abscheidung empfehlen sich Lacke der AZ® 1500er bzw. 4500er Serie.
Entwickler
Zur Entwicklung empfehlen sich entweder TMAH-basierte Entwickler wie der AZ® 326 MIF oder AZ® 726 MIF, der NaOH-basierte AZ® 351B, und bei nicht zu hohen Anforderungen an die Selektivität auch der KOH-basierte AZ® 400K. Beim AZ® 351B oder AZ® 400K kann es zur Erzielung sehr feiner Lackstrukturen oder besser kontrollierbarer Entwicklungsdauern ratsam sein, statt der üblichen 1:4 Verdünnung mit höher verdünnten Entwickleransätzen (zum Beispiel 1:5 bis 1:6) zu arbeiten. Auf alkalisch empfindlichen Substratmaterialien wie Aluminium empfiehlt sich der Aluminium-kompatible AZ® Developer in einer 1:1 Verdünnung.
Removers
Falls die Lackstrukturen weder durch Plasmaprozesse, Ionenimplantation oder durch hohe Temperaturen (> ca. 140°C) thermisch quervernetzt wurden, eignen sich alle gängigen Remover wie zum Beispiel AZ® 100 Remover, DMSO oder viele andere organische Lösemittel (zum Beispiel Aceton, gespült mit Isopropanol) zur Entfernung der Lackschicht. Für quervernetzte Lackstrukturen empfehlen sich Hochleistungs-Stripper wie zum Beispiel die NMP-freien TechniStrip P1316 oder AZ® 920 Remover, im Falle alkalisch empfindlicher Substratmaterialien (wie zum Beispiel Aluminium) der TechniStrip MLO 07.
Verdünnung / Randwallentfernung
Zur Verdünnung für die Schleuderbelackung kommt grundsätzlich PGMEA = AZ® EBR Solvent in Frage, was sich, falls nötig, auch zur Randwallentfernung eignet.
Weitere Informationen
Unsere Sicherheitsdatenblätter und manche unserer Technischen Datenblätter sind passwortgeschützt.
Die Zugangsdaten erhalten Sie nach dem Ausfüllen des Formulars.
Bei den Zugangsdaten für die Datenblätter handelt es sich nicht um Ihre Login-Daten von unserem Shop!
MSDS:
Sicherheitsdatenblatt AZ® ECI 3012 Fotolack englisch
Sicherheitsdatenblatt AZ® ECI 3012 Fotolack deutsch
TDS:
Technisches Datenblatt AZ® ECI 3012 Fotolack englisch
Technisches Datenblatt AZ® ECI 3000 Serie englisch
Anwendungshinweise:
Weitere Informationen zur Fotolack Prozessierung
Ähnliche Produkte
Entwickler
Remover


































