AZ 12XT-20PL-10 Photoresist - 3.785 l












Produktinformationen "AZ 12XT-20PL-10 Photoresist - 3.785 l"
AZ® 12XT-20PL-10
Chemisch verstärkter Positivlack
Allgemeine Informationen
Der AZ® 12XT ist ein chemisch verstärkter, i-line empfindlicher Dicklack für hohe Aspektverhältnisse und mit erhöhtem thermischen Erweichungspunkt.
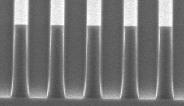
AZ® 12XT - 2.4mm lines at 10mm film thickness
Produkteigenschaften
Der AZ® 12XT deckt einen Lackschichtdickenbereich von ca. 5 - 20 µm ab. Als chemisch verstärkter Lack benötigt der AZ® 12XT keine Rehydrierung zwischen Softbake und Belichtung, braucht verglichen mit nicht chemisch verstärkten Lacken vergleichbarer Dicke deutlich geringere Lichtdosen, setzt beim Belichten keinen Stickstoff frei (keine Bläschenbildung in der Lackschicht beim Belichten), und weist für einen Dicklack sehr hohe Entwicklungsraten auf. Diese Eigenschaften tragen dazu bei, die gesamte Prozessführung deutlich schneller und weniger problemanfällig zu gestalten als mit nicht-chemisch verstärkten Dicklacken. Seine gute Haftung auf allen gängigen Substratmaterialien sowie sein Potenzial steiler Lackflanken machen ihn für die galvanische Abformung geeignet, sein hoher thermischer Erweichungspunkt (ca. 130 °C) empfiehlt ihn auch für das Trockenätzen bzw. DRIE. Grundsätzlich ist der AZ® 12XT nur i-line empfindlich, bei entsprechend hohen Lichtdosen und Lackschichtdicken kann auch mit der h-Linie (405 nm) gearbeitet werden. Falls dünnere Lackschichtdicken als ca. 5 µm erwünscht sind, kann der AZ® 12XT problemlos mit PGMEA = AZ® EBR Solvent verdünnt werden. Für Lackschichtdicken größer 15 µm sollte der ebenfalls chemisch verstärkte AZ® IPS 6090 in Erwägung gezogen werden.
Entwickler
Zur Entwicklung dieses chemisch verstärkten Lacks empfehlen sich TMAH-basierte Entwickler wie die ready-to-use AZ® 326 MIF oder AZ® 726 MIF. KOH-oder NaOH-basierte Entwickler wie der AZ® 400 K oder AZ® 351B sind für den AZ® 12XT weniger geeignet.
Remover
Falls die Lackstrukturen weder durch Plasmaprozesse, Ionenimplantation oder durch hohe Temperaturen (> ca. 140 °C) thermisch quervernetzt wurden, eignen sich alle gängigen Remover wie zum Beispiel AZ® 100 Remover, DMSO oder viele andere organische Lösemittel (zum Beispiel Aceton, gespült mit Isopropanol) zur Entfernung der Lackschicht. Für quervernetzte Lackstrukturen empfehlen sich Hochleistungs-Stripper wie zum Beispiel die NMP-freien TechniStrip P1316 oder AZ® 920 Remover, im Falle alkalisch empfindlicher Substratmaterialien (wie zum Beispiel Aluminium) der TechniStrip MLO 07.
Verdünnung / Randwallentfernung
Falls der Lack für die Schleuderbelackung verdünnt werden soll, kommt PGMEA = AZ® EBR Solvent in Frage. PGMEA stellt ohnehin das Lösungsmittel des AZ® 12XT dar und empfiehlt sich, falls notwendig, ebenfalls zur Randwallentfernung.
Weitere Informationen
Unsere Sicherheitsdatenblätter und manche unserer Technischen Datenblätter sind passwortgeschützt. Die Zugangsdaten erhalten Sie nach dem Ausfüllen des Formulars. Bei den Zugangsdaten für die Datenblätter handelt es sich nicht um Ihre Login-Daten von unserem Shop!
MSDS:
Sicherheitsdatenblatt AZ® 12XT 20PL-10 englisch
Sicherheitsdatenblatt AZ® 12XT 20PL-10 deutsch
TDS:
Technisches Datenblatt AZ® 12XT 20PL-10 englisch
Anwendungshinweis:
Weitere Informationen zur Fotolack Prozessierung
Ähnliche Produkte
Entwickler
Remover






























